Die Diamantdrahtschneidtechnologie, auch bekannt als Konsolidierungs-Schleiftechnologie, nutzt Diamantschleifmittel, das durch Galvanisierung oder Harzbindung auf der Oberfläche eines Stahldrahts aufgebracht wird. Der Diamantdraht wirkt direkt auf die Oberfläche eines Siliziumstabs oder Siliziumblocks ein und erzeugt durch Schleifen den gewünschten Schneideffekt. Diamantdrahtschneiden zeichnet sich durch hohe Schnittgeschwindigkeit, hohe Schnittgenauigkeit und geringen Materialverlust aus.
Der Markt für das Diamantdrahtschneiden von Siliziumwafern mit einkristallinen Siliziumwafern ist mittlerweile gut etabliert, doch traten im Zuge der Markteinführung auch Probleme auf, wobei die sogenannte „Samtweißbildung“ das häufigste Problem darstellt. Daher befasst sich diese Arbeit mit der Frage, wie sich dieses Problem vermeiden lässt.
Der Reinigungsprozess von mit Diamantdraht geschnittenen monokristallinen Siliziumwafern besteht darin, den mit der Drahtsägemaschine geschnittenen Siliziumwafer von der Harzplatte zu trennen, den Gummistreifen zu entfernen und den Siliziumwafer zu reinigen. Die Reinigungsanlagen bestehen hauptsächlich aus einer Vorreinigungsmaschine (Entschleimungsmaschine) und einer Reinigungsmaschine. Der Hauptreinigungsprozess der Vorreinigungsmaschine ist: Zuführung – Sprühen – Sprühen – Ultraschallreinigung – Entschleimung – Spülen mit Reinwasser – Unterzuführung. Der Hauptreinigungsprozess der Reinigungsmaschine ist: Zuführung – Spülen mit Reinwasser – Spülen mit Reinwasser – Alkaliwäsche – Alkaliwäsche – Spülen mit Reinwasser – Spülen mit Reinwasser – Vorentwässerung (langsames Anheben) – Trocknen – Zuführung.
Das Prinzip der Herstellung von Einkristall-Samt
Monokristalline Siliziumwafer weisen eine charakteristische anisotrope Korrosion auf. Das Reaktionsprinzip lässt sich durch folgende chemische Reaktionsgleichung beschreiben:
Si + 2NaOH + H2O = Na2SiO3 + 2H2 ↑
Im Wesentlichen verläuft die Bildung der Wildlederstruktur wie folgt: NaOH-Lösung korrodiert aufgrund der unterschiedlichen Korrosionsraten verschiedener Kristalloberflächen. Die (100)-Oberfläche korrodiert schneller als die (111)-Oberfläche. Daher korrodiert die (100)-Oberfläche des monokristallinen Siliziumwafers anisotrop und bildet schließlich auf der (111)-Oberfläche einen vierseitigen Kegel, die sogenannte „Pyramidenstruktur“ (siehe Abbildung 1). Trifft Licht nach der Strukturbildung unter einem bestimmten Winkel auf die Pyramidenflanke, wird es unter einem anderen Winkel reflektiert. Dies führt zu einer zusätzlichen Absorption und verringert somit die Reflektivität der Siliziumwaferoberfläche – den sogenannten Lichtfalleneffekt (siehe Abbildung 2). Je größer und gleichmäßiger die Pyramidenstruktur ist, desto ausgeprägter ist der Lichtfalleneffekt und desto geringer ist die Oberflächenemission des Siliziumwafers.
Abbildung 1: Mikromorphologie eines monokristallinen Siliziumwafers nach der Alkalibehandlung
Abbildung 2: Das Lichtfallenprinzip der „Pyramiden“-Struktur
Analyse der Einkristall-Aufhellung
Mithilfe eines Rasterelektronenmikroskops wurde an dem weißen Siliziumwafer festgestellt, dass die Pyramidenstruktur in diesem Bereich praktisch nicht ausgebildet war und die Oberfläche einen wachsartigen Rückstand aufwies. Im Gegensatz dazu war die Pyramidenstruktur des Wildleders im weißen Bereich desselben Siliziumwafers besser ausgebildet (siehe Abbildung 3). Befinden sich Rückstände auf der Oberfläche des monokristallinen Siliziumwafers, so weisen die verbleibenden Bereiche eine ungleichmäßige Pyramidenstruktur auf, deren Wirkung im Vergleich zu den normalen Bereichen unzureichend ist. Dies führt zu einer höheren Reflexion der samtartigen Restoberfläche im Vergleich zu den normalen Bereichen. Diese Bereiche mit höherer Reflexion erscheinen im Licht weiß. Wie die Verteilung der weißen Bereiche zeigt, ist diese nicht flächendeckend regelmäßig, sondern nur lokal ausgeprägt. Dies deutet darauf hin, dass die lokalen Verunreinigungen auf der Oberfläche des Siliziumwafers nicht entfernt wurden oder dass die Oberflächenbeschaffenheit durch Sekundärverschmutzung verursacht wurde.
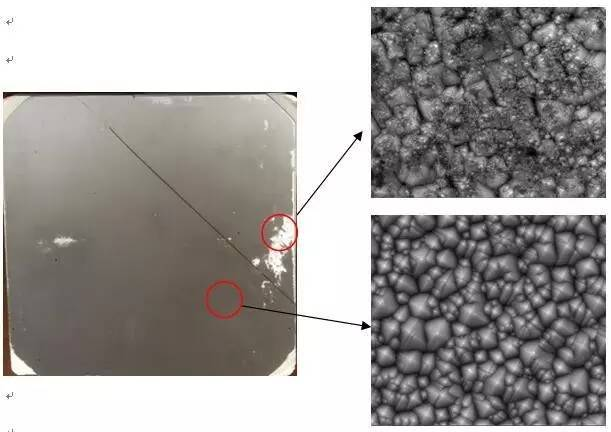
Abbildung 3: Vergleich regionaler Mikrostrukturunterschiede in samtweißen Siliziumwafern
Die Oberfläche des mit Diamantdraht geschnittenen Siliziumwafers ist glatter und weist geringere Beschädigungen auf (siehe Abbildung 4). Im Vergleich zum mit Mörtel geschnittenen Siliziumwafer verläuft die Reaktion zwischen Alkali und der Oberfläche des mit Diamantdraht geschnittenen Siliziumwafers langsamer als beim mit Mörtel geschnittenen monokristallinen Siliziumwafer. Daher ist der Einfluss von Oberflächenrückständen auf den Samteffekt deutlicher.
Abbildung 4: (A) Oberflächenmikrographie eines mit einem Mörser geschnittenen Siliziumwafers; (B) Oberflächenmikrographie eines mit einem Diamantdraht geschnittenen Siliziumwafers
Die Hauptursache für Restemissionen von diamantdrahtgeschnittenen Siliziumwafern
(1) Kühlmittel: Die Hauptbestandteile des Kühlmittels zum Diamantdrahtschneiden sind Tenside, Dispergiermittel, Entschäumer, Wasser und weitere Komponenten. Ein leistungsstarkes Schneidöl zeichnet sich durch gute Suspension, Dispergierbarkeit und einfache Abwaschbarkeit aus. Tenside besitzen in der Regel gute hydrophile Eigenschaften und lassen sich daher beim Reinigen der Siliziumwafer leicht entfernen. Das kontinuierliche Rühren und Zirkulieren dieser Additive im Wasser führt jedoch zu starker Schaumbildung, wodurch der Kühlmittelfluss verringert und die Kühlleistung beeinträchtigt wird. Dies kann zu starker Schaumbildung bis hin zum Überlaufen des Kühlmittels führen und die Anwendung erheblich beeinträchtigen. Daher wird dem Kühlmittel üblicherweise ein Entschäumer beigemischt. Um eine ausreichende Entschäumung zu gewährleisten, sind herkömmliche Silikone und Polyether oft schlecht hydrophil. Das Lösungsmittel im Wasser adsorbiert leicht auf der Oberfläche der Siliziumwafer und verbleibt dort während der nachfolgenden Reinigung, was zu weißen Flecken führt. Da es mit den Hauptkomponenten des Kühlmittels nicht gut kompatibel ist, muss es in zwei Komponenten aufgeteilt werden: Hauptkomponenten und Entschäumer werden in Wasser gelöst. Im Betrieb lässt sich die Menge und Dosierung der Entschäumer je nach Schaumbildung nicht quantitativ steuern, was leicht zu einer Überdosierung und damit zu vermehrten Rückständen auf der Siliziumwafer-Oberfläche führen kann. Die Handhabung ist zudem umständlicher. Aufgrund der niedrigen Rohstoffpreise für Entschäumer wird dieses System jedoch von den meisten inländischen Kühlmittelherstellern verwendet. Ein anderes Kühlmittel verwendet einen neuen Entschäumer, der gut mit den Hauptkomponenten kompatibel ist, keine Zusätze benötigt und dessen Menge effektiv und quantitativ kontrolliert werden kann. Dadurch wird eine Überdosierung wirksam verhindert. Die Handhabung ist ebenfalls sehr einfach. Mit der richtigen Reinigung lassen sich die Rückstände auf ein sehr niedriges Niveau reduzieren. In Japan und bei einigen inländischen Herstellern wird dieses System verwendet. Aufgrund der hohen Rohstoffkosten ist der Preisvorteil jedoch nicht deutlich.
(2) Klebstoff- und Harzversion: Im späteren Stadium des Diamantdrahtschneidprozesses ist die Siliziumscheibe nahe dem Eintrittsende bereits durchtrennt, während sie am Austrittsende noch intakt ist. Der frühzeitig geschnittene Diamantdraht hat bereits begonnen, die Gummischicht und die Harzplatte zu durchtrennen. Da sowohl der Klebstoff des Siliziumdrahts als auch die Harzplatte Epoxidharzprodukte sind, liegt ihr Erweichungspunkt üblicherweise zwischen 55 und 95 °C. Ist der Erweichungspunkt der Gummischicht oder der Harzplatte niedrig, kann es während des Schneidprozesses leicht zu Erhitzung, Erweichung und Schmelzen kommen. Das Harz haftet dann am Stahldraht und an der Oberfläche der Siliziumscheibe, wodurch die Schneidleistung des Diamantdrahts verringert wird. Alternativ kann Harz auf die Siliziumscheibe gelangen und diese verunreinigen. Einmal anhaftend, lässt sich das Harz nur sehr schwer entfernen. Solche Verunreinigungen treten meist in der Nähe der Kanten der Siliziumscheibe auf.
(3) Siliziumpulver: Beim Diamantdrahtschneiden entsteht viel Siliziumpulver. Mit fortschreitendem Schneiden steigt der Anteil an Siliziumpulver im Kühlmittel. Sobald genügend Pulver vorhanden ist, haftet es an der Siliziumoberfläche. Die Partikelgröße des Siliziumpulvers beim Diamantdrahtschneiden verstärkt diese Adsorption und erschwert die Reinigung. Daher ist es wichtig, die Kühlmittelqualität zu verbessern und den Pulveranteil im Kühlmittel zu reduzieren.
(4) Reinigungsmittel: Die meisten Hersteller von Diamantdrahtschneidanlagen verwenden derzeit Mörtelschneiden. Dabei kommen Vorreinigung, Reinigungsprozess und Reinigungsmittel zum Einsatz. Die Technologie des Diamantdrahtschneidens, die vom Schneidmechanismus bis zum Mörtelschneiden reicht, unterscheidet sich hinsichtlich Kühlmittel und Mörtelschneiden erheblich. Daher müssen Reinigungsprozess, Dosierung und Zusammensetzung des Reinigungsmittels für das Diamantdrahtschneiden entsprechend angepasst werden. Das Reinigungsmittel ist ein wichtiger Aspekt. Herkömmliche Reinigungsmittel mit Tensiden und Alkalität sind für die Reinigung von Siliziumwafern beim Diamantdrahtschneiden ungeeignet. Es sollte ein Reinigungsmittel verwendet werden, dessen Zusammensetzung und Zusammensetzung speziell auf die Oberfläche des Siliziumwafers abgestimmt sind und das im Reinigungsprozess berücksichtigt wird. Wie bereits erwähnt, ist beim Mörtelschneiden kein Entschäumer erforderlich.
(5) Wasser: Beim Diamantdrahtschneiden, Vorwaschen und Reinigen kann Überlaufwasser Verunreinigungen enthalten, die an der Oberfläche des Siliziumwafers adsorbiert werden können.
Vorschläge zur Reduzierung des Problems, dass samtiges Haar weiß erscheint
(1) Um ein gut dispergierbares Kühlmittel zu verwenden, ist es erforderlich, dass dem Kühlmittel ein rückstandsarmes Entschäumungsmittel beigemischt wird, um die Rückstände der Kühlmittelkomponenten auf der Oberfläche des Siliziumwafers zu reduzieren.
(2) Verwenden Sie geeignete Klebstoffe und Harzplatten, um die Verschmutzung der Siliziumwafer zu reduzieren;
(3) Das Kühlmittel wird mit reinem Wasser verdünnt, um sicherzustellen, dass im verwendeten Wasser keine leicht verbleibenden Verunreinigungen vorhanden sind.
(4) Für die Oberfläche von diamantdrahtgeschnittenen Siliziumwafern ist ein Reinigungsmittel mit höherer Aktivität und Reinigungswirkung geeignet.
(5) Durch den Einsatz des Online-Kühlmittelrückgewinnungssystems mit Diamantlinien wird der Siliziumpulveranteil im Schneidprozess reduziert und somit der Siliziumpulverrückstand auf der Oberfläche des Siliziumwafers effektiv kontrolliert. Gleichzeitig können Wassertemperatur, Durchfluss und Spülzeit beim Vorspülen optimiert werden, um ein rechtzeitiges Abspülen des Siliziumpulvers zu gewährleisten.
(6) Sobald der Siliziumwafer auf dem Reinigungstisch platziert ist, muss er sofort behandelt werden und während des gesamten Reinigungsprozesses feucht gehalten werden.
(7) Die Siliziumscheibe bleibt während des Entschleimungsprozesses feucht und kann nicht natürlich trocknen. (8) Um die Bildung von Ausblühungen auf der Oberfläche der Siliziumscheibe zu verhindern, sollte die Zeit, die die Scheibe während der Reinigung an der Luft verbringt, so weit wie möglich reduziert werden.
(9) Das Reinigungspersonal darf während des gesamten Reinigungsprozesses die Oberfläche des Siliziumwafers nicht direkt berühren und muss Gummihandschuhe tragen, um keine Fingerabdrücke zu hinterlassen.
(10) In Referenz [2] wird für die Reinigung der Batterieenden eine Lösung aus Wasserstoffperoxid (H₂O₂) und Natronlauge (NaOH) im Volumenverhältnis 1:26 (3%ige NaOH-Lösung) verwendet, wodurch das Auftreten des Problems effektiv reduziert werden kann. Das Prinzip ähnelt der SC1-Reinigungslösung (bekannt als Flüssigkeit 1) für Siliziumwafer. Der Hauptmechanismus besteht darin, dass sich auf der Oberfläche des Siliziumwafers durch die Oxidation von H₂O₂ ein Oxidfilm bildet, der durch NaOH korrodiert wird. Dieser Oxidations- und Korrosionsprozess wiederholt sich. Dadurch gelangen auch Partikel, die an Siliziumpulver, Harz, Metall usw. haften, zusammen mit der Korrosionsschicht in die Reinigungsflüssigkeit. Durch die Oxidation von H₂O₂ werden die organischen Substanzen auf der Waferoberfläche in CO₂ und H₂O zersetzt und entfernt. Dieses Reinigungsverfahren wird von Siliziumwafer-Herstellern zur Reinigung von mit Diamantdraht geschnittenen monokristallinen Siliziumwafern eingesetzt. Es gibt jedoch Beschwerden über das Problem der samtig-weißen Ablagerungen, das bei der Chargenverarbeitung von Siliziumwafern durch Batteriehersteller in China, Taiwan und anderen Ländern auftritt. Auch andere Batteriehersteller nutzen ein ähnliches Vorreinigungsverfahren für die Samtbeschichtung und können so das Auftreten von weißen Ablagerungen an den Batterieenden wirksam verhindern. Dieser Reinigungsprozess wird dem Reinigungsprozess der Siliziumwafer hinzugefügt, um Siliziumwafer-Rückstände zu entfernen und somit das Problem der weißen Ablagerungen an den Batterieenden effektiv zu lösen.
Abschluss
Das Diamantdrahtschneiden hat sich mittlerweile als wichtigste Bearbeitungstechnologie beim Schneiden von Einkristallen etabliert. Allerdings stellt das Problem der samtig-weißen Oberflächenverfärbung ein Problem für Hersteller von Siliziumwafern und Batterien dar, was bei Batterieherstellern zu Vorbehalten gegenüber dem Diamantdrahtschneiden von Siliziumwafern geführt hat. Eine vergleichende Analyse der weißen Bereiche zeigt, dass diese hauptsächlich durch Rückstände auf der Oberfläche der Siliziumwafer verursacht werden. Um dieses Problem in der Zelle besser zu vermeiden, analysiert diese Arbeit die möglichen Quellen der Oberflächenverunreinigung von Siliziumwafern sowie Verbesserungsvorschläge und Maßnahmen für die Produktion. Anhand von Anzahl, Lage und Form der weißen Flecken können die Ursachen analysiert und entsprechende Maßnahmen ergriffen werden. Besonders empfohlen wird die Reinigung mit Wasserstoffperoxid und Alkali. Die erfolgreiche Anwendung dieses Verfahrens hat gezeigt, dass es die samtig-weiße Oberflächenverfärbung beim Diamantdrahtschneiden von Siliziumwafern effektiv verhindern kann und dient als Referenz für Branchenexperten und Hersteller.
Veröffentlichungsdatum: 30. Mai 2024